CMOS制造中的轻掺杂漏(LDD)注入工艺
版图
0 字 / 约 0 分钟
2011/8/5
CMOS 制造第四步,防短沟道、降漏电、造浅结,一步到位。
1. 为什么需要 LDD?
- 栅宽 ↓ → 沟道长度 ↓ → 短沟道效应 ↑
- 高电场 → 热载流子退化 & 漏电流 ↑
- 解决思路:在源/漏与沟道之间插入 低浓度、浅结 过渡区 → LDD
2. LDD 工艺总览
| 步骤 | 目的 | 关键工艺 |
|---|---|---|
| N-LDD | NMOS 侧轻掺杂 | 砷 (As) 注入 + 表面非晶化 |
| P-LDD | PMOS 侧轻掺杂 | BF₂ 注入 + 表面非晶化 |
均为第四步制造步骤,紧接栅极形成后。
3. 流程拆解
3.1 N-LDD
- 光刻
- 胶开窗:仅暴露 NMOS 区域
- 离子注入
- As⁺ (砷):大质量 → 浅结 + 表面非晶化
- 能量低 → 结深 < 50 nm
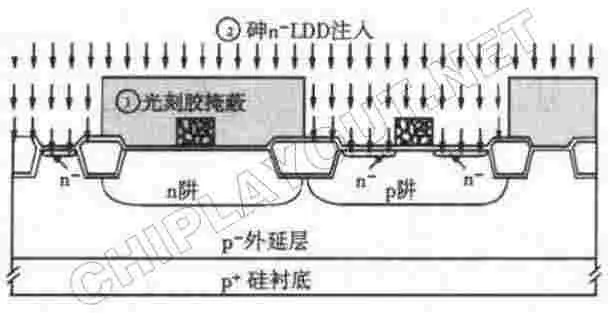
3.2 P-LDD
- 光刻
- 胶开窗:仅暴露 PMOS 区域
- 离子注入
- BF₂⁺ (氟化硼):比 B⁺ 更重,非晶化更好
- 同样低能浅结,抑制硼扩散
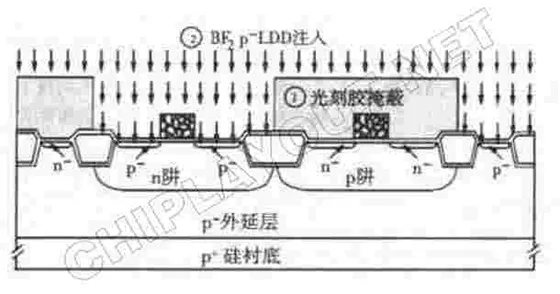
4. 工艺收益
| 效果 | 机制 |
|---|---|
| 抑制短沟道 | 低浓度扩散区降低峰值电场 |
| 减小漏电流 | 浅结 + 非晶化 → 缺陷复合中心 ↓ |
| 提升可靠性 | 热载流子注入 (HCI) 降低 |
5. 一句话总结
LDD = “轻掺杂 + 浅结 + 非晶化”,用最小剂量把源漏电场“削峰”,让短沟道器件既快又稳。
CMOS制作基本步骤的相关文章
- CMOS制作步骤(一):双阱工艺(twin well process)
- CMOS制作步骤(二):浅槽隔离工艺STI(shadow trench isolation process)
- CMOS制作步骤(三):多晶硅栅结构工艺(poly gate structural process)
- CMOS制作步骤(四):轻掺杂漏注入工艺LDD(lightly doped drain implants process)
- CMOS制作步骤(五):侧墙的形成(side wall spacer formation)
- CMOS制作步骤(六):源/漏注入工艺(S/D implant process)
- CMOS制作步骤(七):接触(孔)形成工艺(contact formation)
- CMOS制作步骤(八):局部互连工艺LI(Local Interconnect process)
- CMOS制作步骤(九):Via-1, Plug-1及Metal-1互连的形成(Via-1 and Plug-1 formation)
- CMOS制作步骤(十):Via-2, Plug-2,Metal-2及Top Metal形成(Via-2,Plug-2,metal2 interconnect and top metal formation)